Проявление - слой
Cтраница 1
Проявление слоя ПВС проводится в проточной воде при температуре 50 - 60 С, а фоторезиста - в водном растворе фосфорнокислого натрия с глицерином. [1]
В процессе проявления везикулярного слоя по сути дела и происходит образование дисперсии газовых пузырьков в пленке полимера. [2]
 |
Параметры светочувствительности слоев для офсета без увлажнения, содержащих 2 в-бис ( 4-азидобензилиден - 4-метилциклогексанон. [3] |
Для упрощения контроля проявления фотоструктурированного слоя в композицию были введены органические пигменты. [4]
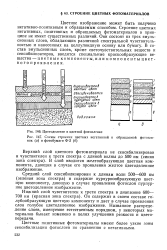 |
Цветоделение в цветной фотоплен. [5] |
Он содержит в своем составе го-лубообразующую цветную компоненту и дает в случае проявления слоя голубое цветоделенное изображение. [6]
Он содержит в своем составе голубообразующую цветную компоненту и дает в случае проявления слоя голубое цветоделенное изображение. [7]
Метод ТСХ в сочетании с фотоденситометрическим определением концентрации веществ в пятнах, полученных в результате проявления слоя путем обугливания парами SO3, позволяет также осуществлять ускоренный анализ исходных фракций а-олефинсульфонатов с целью определения олефинсульфонатов и оксиалканмоносульфонатов. [8]
Известно несколько разработок позитивных резистов использованием относительно простых солей диазония или бисдиазония, когда после экспонирования их в полимерной матрице и проявлении слоя в основаниях нерастворимый рельеф образуется в нефотолнзованных участках, а не в местах действия света. Однако выбор подобных систем достаточно сложен. [9]
Известно несколько разработок позитивных резистов ч использованием относительно простых солей диазония или бисдиазония, когда после экспонирования их в полимерной матрице и проявлении слоя в основаниях нерастворимый рельеф образуется в нефотолизованных участках, а не в местах действия света. Однако выбор подобных систем достаточно сложен. [10]
Фотолитография включает след, стадии: нанесение слоя фоторезиста на пленку 81О2, покрывающую кремниевую пластину; экспонирование слоя фоторезиста через фотошаблон-стеклянную пластину с множеством одинаковых рисунков областей прибора; проявление слоя фоторезиста; получение оксидной маски травлением пленки 8Ю2 через окна в проявленном фоторезисте; удаление фоторезиста. Используют фотолитографию контактную ( фотошаблон контактирует со слоем фоторезиста) и проекционную, осуществляемую либо однократным проецированием фотошаблона с множеством структур на всю пов-сть пластины, либо пошаговым экспонированием, при к-ром на пластину с определенным сдвигом ( шагом) многократно проецируют фотошаблон с изображением одной структуры. Кроме фотолитографии используют также рентгеновскую и электронную литографию. [11]
Ниже указана последовательность операций при использовании двухслойной полисилоксановой системы: 1) нанесение центрифугированием на подложку из раствора слоя планаризационного резиста толщиной 2 5 - 3 мкм; 2) предэкспозиционная термообработка ( 200 С); 3) нанесение центрифугированием из раствора слоя полисилоксана толщиной 0 25 - 0 3 мкм на слой планаризационного резиста; 4) экспонирование пучком электронов или УФ-светом с длиной волны 220 нм; 5) проявление полисилоксанового слоя растворителем; 6) ИХТ плапаризационного слоя. [12]
Ниже указана последовательность операций при использовании двухслойной полнсилоксановой системы: 1) нанесение центрифугированием на подложку нз раствора слоя планарнзацнонного резиста толщиной 2 5 - 3 мкм; 2) предэкспозицнонная термообработка ( 200 С); 3) нанесение центрифугированием из раствора слоя полиснлоксана толщиной 0 25 - 0 3 мкм на слой планаризацнонного резиста; 4) экспонирование пучком электронов или УФ-светом с длиной волны 220 нм; 5) проявление полисилоксанового слоя растворителем; 6) ИХТ планаризационного слоя. [13]
 |
Схема изготовления биметаллической свободной маски. [14] |
После проявления и задубливания фоторезистивного слоя ( рис. 30, г) образуется защитный рельеф для последующего никелирования. Проявление слоя ПВС проводится в проточной воде при температуре 50 - 60 С, а фоторезиста - в водном растворе фосфорнокислого натрия с глицерином. [15]
Страницы: 1 2