Распыление - мишень
Cтраница 1
 |
Схема источника положительных ионов углерода на основе дуоплазмотроча для напыления тонких алмазсподобных пленок. [1] |
Распыление мишени может осуществляться различными способами: в ВЧ-разряде; магнетронным распылением; пучком высокоэнергетических ионов инертных газов; лазерным пучком. [2]
Катодное и ионноплазменнов распыление - распыление мишени ( катода) в результате бомбардировки ее положительными ионами инертного газа из плазмы, образующейся в газовом разряде. Энергия нейтральных частиц, выбиваемых ионами из мишени, колеблется от единиц до нескольких десятков электрон-вольт. [3]
В работе [24] с помощью магнетронного распыления мишени Nio 75Alo 25 и сажДения металлических паров на аморфную подложку получены интерметаллидные пленки N13 A1 со средним размером кристаллитов порядка 20 нм. [4]
Флур и Райзман [108] установили, что пленки, полученные путем распыления пермаллоевой мишени ( NisiFeig), имеют такой же состав, как и мишень. [5]
Процесс ионного распыления соединений, таких, например, как окислы, несомненно более сложен, чем распыление мишеней из простых веществ - химических элементов. Передача импульса от падающего иона эмиттируемому атому посредством нескольких атомных столкновений является интенсивным процессом. Энергия, которая при этом передается, может, несомненно, превышать энергию химической связи, типичная величина которой порядка нескольких электрон-вольт. В результате возможен разрыв многих связей. [6]
 |
Зависимость удельной электропроводности гндрогеннзнрованного аморфного кремния при комнатной температуре от состава газовой смеси. [7] |
Легируют пленки a - Si: H тремя способами: введением в газовую смесь фос-фина или диборана ( что нежелательно из-за их высокой токсичности); одновременным распылением кремния и легирующего материала; распылением кремниевой мишени, легированной в заданном количестве нужной примесью. [8]
 |
Пробеги и дисперсии пробегов ионов В и As с энергией Е0 в SiO.| Значения коэффициента а ( примесь В, маска SiO2 Ослабление пучка QS / Q. [9] |
Распыление поверхностного слоя кристалла в процессе ионного внедрения одновременно с проникновением ионов в глубину кристалла происходит вследствие отрыва атомов под действием ионов, энергия которых значительно превышает энергию связи атома на поверхности. Распыление мишени может оказать влияние на конечный профиль распределения ионов, а также привести к тому, что общее количество внедренных ионов окажется меньше дозы облучения. [10]
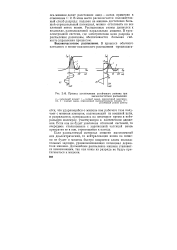 |
Процесс установления устойчивого режима при. [11] |
Если распыляемый материал мишени высокоомный или диэлектрический, то нейтрализации ионов на мишени не будет и мишень быстро покроется слоем положительных зарядов, уравновешивающих потенциал держателя мишени. Дальнейшее распыление мишени становится невозможным, так как ионы из разряда не будут притягиваться к мишени. [12]
Качество пленок, осаждаемых методом ионного распыления [194], существенно зависит от размера частиц вещества, из которого изготовлена мишень. При распылении мелкозернистых мишеней образуются многофазные пленки с дефицитом Se и избытком In, тогда как при использовании крупнозернистых мишеней осаждаются пленки стехиометрического состава, которые, согласно результатам рентгеноструктурного анализа, имеют структуру сфалерита или халькопирита. Установлено, что температура подложки влияет на кристаллическую структуру и размер зерен пленок, но не оказывает воздействия на их состав. При ионном распылении крупнозернистых мишеней на подложках, имеющих низкую температуру ( 20 С), образуются аморфные пленки. С пленки кристаллизуются в структуре сфалерита. С осаждаемые пленки имеют структуру халькопирита и состоят из ориентированных зерен. В пленках, получаемых при высокой температуре, размер зерен равен 1 мкм. [13]
Очистка подложек значительно упрощается, поскольку перед осаждением пленок можно осуществлять очистку поверхности подложек ионной бомбардировкой. В случае предварительного распыления мишени для установления в системе стационарных температуры и давления весьма полезной и даже необходимой оказывается установка заслонки между ми-шеныо и подложкой. [14]
Уменьшению толщины пленки на краях подложки, однако, противодействует увеличение скорости уноса материала с краев мишени, вызванное заметным ростом локальных градиентов поля. Чтобы избежать неравномерности распыления мишени, целесообразно использовать экраны с боковым охватом мишени. Это позволяет снизить унос вещества с краев и создать такое распределение скорости распыления мишени, которое обеспечивает равномерность толщины пленки на уровне 5 - 10 % по всей поверхности подложки. Для этого необходимо соблюдать также строго параллельное расположение электродов относительно друг друга. Расстояние между электродами сильно влияет на скорость распыления, например увеличение расстояния от 2 5 дб 10 см приводило к снижению скорости распыления в 10 раз. [15]
Страницы: 1 2 3