Геттерирование
Cтраница 1
Геттерирование и формирование преципитатов атомов никеля и кобальта на поверхности можно понять, проанализировав данные но диффузии и растворимости этих элементов. Поскольку растворимость кобальта ниже, чем никеля, при практически равных значениях D Геттерирование и образование преципитатов для атомов кобальта происходит медленнее по сравнению с атомом никеля. [1]
Эффект геттерирования основан на высокой растворимости нежелательной примеси в геттере, находящемся в контакте с полупроводником. [2]
Процессы геттерирования начали широко использоваться в технологии создания интегральных схем уже при работе с пластинами диаметром 75 мм. Пока толщина пластины оставалась сравнительно небольшой, наиболее удачной областью для формирования геттерирующей среды являлась обратная сторона пластины. В качестве геттерирующих сред использовались: нарушенные слои, создаваемые путем прецизионной механической обработки; имплантированные слои; слои, создаваемые диффузионным введением до высоких концентраций тех или иных легирующих примесей; пленки поликристаллического кремния и различных силикатов, осаждаемые на нерабочей поверхности пластины. [3]
Причина геттерирования заключается, по-видимому, в том, что в дефектной области, созданной ионной бомбардировкой, происходит распад твердого раствора и осаждение примеси на дефектах, а это вызывает восходящую диффузию из объема к поверхности. [4]
Смысл процесса геттерирования заключается в удалении загрязняющей примеси из активной области приборной композиции путем ее локализации в определенной фиксированной области пластины, где она не может повлиять на характеристики создаваемых приборов. В основе процессов геттерирования лежат фундаментальные физические процессы, связанные либо с контролируемым формированием центров гетерогенного зарождения преципитатов при распаде пересыщенного твердого раствора загрязняющей примеси, либо с формированием среды, обладающей повышенной ( по сравнению с рабочей областью приборной структуры) растворимостью загрязняющей примеси. [5]
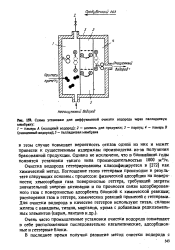 |
Схема установки для диффузионной очистки водорода через палладиевую. [6] |
Очистка водорода геттерированием классифицируется в [272] как химический метод. Поглощение газов геттерами происходит в результате следующих основных процессов: физической адсорбции на поверхности; хемосорбции газа поверхностью геттера, требующей затраты значительной энергии активации и по прочности связи адсорбированного газа с поверхностью адсорбента близкой к химической реакции; растворения газа в геттере, химических реакций примесей с геттерами. [7]
Если исследования по геттерированию загрязняющих примесей из активных областей кремниевых приборных структур успешно ведутся уже на протяжении многих лет, то для других полупроводниковых материалов ( за редким исключением) эти работы находятся практически на начальном этапе и нуждаются в серьезной интенсификации. [8]
При распылении с геттерированием [23, 24], прежде чем начинается образование пленки за счет катодного распыления, из газа за счет реактивного распыления удаляются ( геттерируются) химически активные составляющие. Такой метод дает пленки очень высокой чистоты. В типичной установке для напыления с геттерированием в системе кроме обычной подложки, анода, имеется второй анод. Этот анод имеет форму экрана, окружающего катод и подложку. Сначала подложку закрывают заслонкой, чтобы предотвратить осаждение пленки, и все химически активные газы внутри экрана удаляют за счет поглощения в металле, распыленном из катода и осевшем на стенках сосуда. В результате этого давление химически активных газов в системе можно уменьшить до 10 - 1С мм рт. ст. Чтобы достичь такого давления в обычной системе, требуются сложные насосы и длительное обезгаживание. После геттерирования заслонку отводят и катод распыляют на подложку. Выделение газов из стенок сосуда сдерживается напыленными слоями металлических соединений. Экран делают плотно прилегающим к катоду и аноду, так что диффузия примесей из остальной части системы затруднена. Сначала систему откачивают до - 10 - 6 мм рт. ст. и при температуре приблизительно на 50 выше температуры осаждения производят обезгаживание подложки. Вообще говоря, необходимо независимое регулирование температуры подложки. В качестве газа обычно используют Аг, и реактивного распыления в течение 15 - 30 мин обычно достаточно, чтобы очистить атмосферу. Стойрер и Хозер [24] на стадии разложения использовали давление Аг в интервале ( 31 - 4 - 185) 10 - 3 мм рт. ст. До сих пор специального упора на выращивание монокристаллов не делалось, и это потребует, вероятно, более высоких температур подложки и применения монокристальных подложек. Распыление с геттерированием дает возможность изучать механизмы роста кристаллов в сверхчистых условиях, а также получать сверхчистые пленки. [9]
Однако при некоторых условиях достаточно активное геттерирование не происходит и могут наблюдаться компенсация донорной примеси Ge и уменьшение ее электрической активности. В том случае, когда количество легирующей примеси в источнике ограничено, необходимо принять меры для того, чтобы обеспечить ее высокую концентрацию в поверхностном слое полупроводника, который несколько толще образующегося затем обедненного слоя. [10]
Для каждого из рассмотренных вариантов геттерирования существует своя производственная ниша, определяющая целесообразность его применения. Для геттерирования с использованием сегрегационных эффектов это интервал температур, в котором загрязняющая примесь имеет достаточно высокую диффузионную подвижность, а эффект сегрегации максимален. Для распадного геттерирования - это интервал температур, в котором загрязняющая примесь может образовать пересыщенный твердый раствор и в то же время оставаться достаточно подвижной для того, чтобы продиффундировать к геттерирующим стокам и там преци-питировать. [11]
Поскольку инертные газы не поддаются химическому захвату, титановое геттерирование является только вспомогательным методом получения вакуума. Он постоянно используется в ионных насосах для увеличения их быстроты откачки. Эффективность использования комбинированного химического геттерирования и криогенной откачки при предельно низких давлениях не ограничивается системами ионной откачки. Эти ловушки устанавливаются между насосом и вакуумной камерой. [12]
Очистку от указанных примесей в современной технологии полупроводников проводят адсорбционными методами, геттерированием, диффузионным методом. [13]
 |
Ловушки для паров ртути. [14] |
При получении вакуума остатки газа в откачиваемом сосуде часто связывают химически; это называют геттерированием. Например, при производстве электроламп откачку производят только до № - мм рт. ст., после чего, возбуждая в остаточном газе электрический разряд, осаждают на внутренней поверхности стеклянной колбы очень тонкий прозрачный слой красного фосфора, предварительно введенного в колбу. [15]
Страницы: 1 2 3