Температурная зависимость - скорость - рост
Cтраница 1
Температурная зависимость скорости роста для винилхлорида проявляется в меньшей степени, чем для стирола, а скорости обрыва - в большей. Поэтому повышение температуры полимеризации винилхлорида приводит к получению полимера с меньшей средней молекулярной массой, нежели при синтезе полистирола. [1]
 |
Кривые изменения скорости роста пленок германия в зависимости от концентрации GeCl4 в водороде при различных tn и на разных гранях монокристаллов германия. [2] |
Температурная зависимость скорости роста германия при восстановлении его тетрахлорида изучена хуже, чем для кремния в аналогичном процессе. [3]
 |
Температурные зависимо стн скоростей зародышеобразоналня. [4] |
Температурная зависимость скорости роста кристаллов практически аналогична температурной зависимости зароды ие-образования, но сдвинута по оси абсцисс в сторону меньших переохлаждений ( см рнс. [5]
На рис. 1 показана температурная зависимость скорости роста слоев на подложках Si ( HO), снятая для трех концентраций тетрахлорида кремния в водороде: 0 7 % SiCl. В зависимости от структурного совершенства слоев можно выделить три области наращивания, соответствующие определенным температурам и концентрациям SiC. [6]
 |
Зависимость скорости роста эпитаксиальных пленок кремния от температуры осаждения. [7] |
На рис. 2.4 представлены данные о температурной зависимости скорости роста по данным разных авторов. Тойерер [13] считает, что зависимость скорости осаждения от величины, обратной температуре, линейна во всем изученном интервале 900 - 1300 С. Вычисленная по этим данным энергия активации процесса равна 37 ккал / молъ. При оптимальном режиме ( Csjcu 0 02, vu 1 л / мин, ta 1270 С) осаждение идет со скоростью 1 6мк / мин. [8]
Эти авторы установили, что для обоих случаев применим общий механизм температурной зависимости скорости роста пленок. Они также показали, что температурная зависимость скорости роста пленок будет обратной, если пленка наносится методом реактивною распыления. В данном случае скорость нанесения увеличивается с повышением температуры подложки. К этому вопросу мы еще вернемся в разд. [9]
 |
Структуры сплава Си 4 3 % Ti после изотермического распада, X оОО. [10] |
Температурная зависимость скорости роста колоний и видманштеттовых кристаллов имеет экстремальный характер. В сплаве Си 4 3 % Ti максимумы сдвинуты на 35 С. [11]
Эти авторы установили, что для обоих случаев применим общий механизм температурной зависимости скорости роста пленок. Они также показали, что температурная зависимость скорости роста пленок будет обратной, если пленка наносится методом реактивною распыления. В данном случае скорость нанесения увеличивается с повышением температуры подложки. К этому вопросу мы еще вернемся в разд. [12]
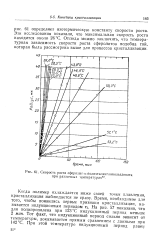 |
Скорость роста сферолигоь лолиэтиленгликольадипата. при различных температурах22. [13] |
Эти исследования показали, что максимальная скорость роста находится около 26 С. Отсюда можно заключить, что температурная зависимость скорости роста сферолитов подобна той, которая была рассмотрена выше для процессов кристаллизации. [14]
Предполагая только, что скорость роста кристаллов определяется скоростью вторичного зародышеобразования, авторам удалось добиться разумного соответствия между экспериментальными и вычисленными скоростями роста. Такая зависимость определяет значительно большую степень переохлаждения для заметного роста кристаллов и гораздо менее резкое увеличение скорости кристаллизации при увеличении ДГ. На рис. 5.36 приведена температурная зависимость скорости роста кристаллов, которая определяется скоростью вторичного зародышеобразования. Из общей диаграммы видно, что в выбранных условиях кристаллизации должна существовать область переохлаждения около 7 С ( заштрихованная область), где расплав ме-тастабилен. Даже добавление кристаллов в качестве зародышей не может инициировать процесс кристаллизации в заметной степени. Далее этой области в интервале температур 40 С или более рост кристалла невозможен при гомогенном зародышеобразовании, но, начавшись на гетерогенном зародыше, он будет продолжаться путем последовательного вторичного зародышеобразования. И наконец, в области температур, близких к температуре стеклования, скорости как первичного, так и вторичного зародышеобразования становятся очень малыми. [15]
Страницы: 1 2