Быстродействие - транзистор
Cтраница 1
 |
Гистограммы напряжений пробоя диффузионных транзисторов. [1] |
Быстродействие транзистора в лавинном режиме оценивается временем нарастания / н импульсов, которое измеряется на уровне 0 1 - 0 9 от амплитуды. Измерения могут проводиться в схеме рис. 3 или других схемах релаксационных генераторов. [2]
Для характеристики быстродействия транзистора необходимо использовать следующие параметры: / V, Сэ, Ск, Вст и параметр, характеризующий скорость переходных процессов в насыщенном режиме. Здесь необходимо сделать отступление и рассмотреть вопрос о связи таких параметров, как время жизни неосновных носителей заряда и постоянная времени, определяющая скорость переходного процесса в транзисторе. [3]
 |
Схема измерения напряжения переворота фазы базового тока. [4] |
Специфика анализа быстродействия транзисторов в импульсных схемах связана с циклическим перемещением рабочей точки в процессе переключения. [5]
Более удачным методом повышения быстродействия транзистора, работающего в качестве переключателя, является шунтирование коллекторного перехода диодом Шоттки, в котором отсутствует инжекция неосновных носителей и их накопление при прямом смещении. Структура и принцип действия такого транзистора будут рассмотрены в § 7.4, так как наибольшее применение биполярные транзисторы с диодом Шоттки получили в интегральных микросхемах. [6]
 |
Временные зависимости тока базы ( а и тока коллектора ( б при работе транзистора в качестве ключа по схеме с общим эмиттером. [7] |
Более удачным методом повышения быстродействия транзистора, работающего в качестве электронного ключа, является шунтирование коллекторного перехода диодом Шотки, в котором при прямом смещении отсутствуют инжекция неосновных носителей заряда и их накопление. Структура и принцип действия такого транзистора с диодом Шотки будут рассмотрены в § 7.4, так как наибольшее распространение такие транзисторы получили в интегральных микросхемах. [8]
 |
Основные этапы формирования эпи-таксиально-планарной структуры типа д - р-п. [9] |
Рассмотренная технология позволяет получить низко-омный коллектор, что повышает быстродействие транзистора, и исключить одну операцию диффузии и одну операцию совмещения по сравнению с известной технологией, представленной на рис. 1.5. Кроме того, площадь транзистора уменьшается на 40 - 50 % по сравнению с обычной эпитаксиальио-планарной структурой. [10]
Чем выше степень насыщения, тем больше накапливается в базе дырок и тем хуже быстродействие транзистора. [11]
 |
Интегральный диод. [12] |
Величина емкости перехода коллектор-подложка для маломощных структур имеет величину от 2 до 5 пФ и существенно сказывается на быстродействии транзистора. [13]
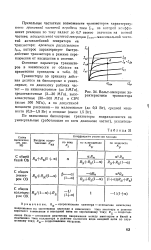 |
Вольт-амперные характеристики транзистора. [14] |
ГР, на которой коэффициент усиления по току падает до 0 7 своего значения на низкой частоте; максимальной частотой генерации fma - максимальной частотой автоколебаний генератора на транзисторе; временем рассасывания tpac, которое характеризует быстродействие транзистора в режиме переключения от насыщения к отсечке. [15]
Страницы: 1 2 3