Распыление - поверхность
Cтраница 1
Распыление поверхностей под действием пучков положительных ионов низкой энергии. [1]
В случае обезжиривания распылением поверхности перед фосфатированием должны быть обеспечены условия для формирования равномерной плотной мелкокристаллической фосфатной пленки. [2]
 |
Структура поверхности металла после ионной обработки. [3] |
При ионной бомбардировке и распылении поверхности ионами с энергией ( 1 6 - 2 4) 10 - 19кДж наблюдается преимущественное травление границ зерен подложки и одновременно конденсация микрокапельной фазы. Капли металла, конденсирующиеся на начальной стадии процесса практически на холодную основу, имеют низкую прочность сцепления, так как их скорость невелика, а диффузионные процессы недостаточно эффективны. Вместе с тем формирование слоя на начальной стадии нанесения покрытий в значительной мере определяет свойства и структуру покрытия в целом. При дальнейшей ионной бомбардировке стимулируются диффузионные процессы как за счет температуры, так и вследствие импульса энергии ионной компоненты. В результате конденсированные на стадии ионной бомбардировки макрочастицы прочно сцепляются с основой и становятся центрами, кристаллизации для осаждающего потока частиц в режиме конденсации. На рис. 4.5 показана структура островка - йапли катодного материала, осажденной в режиме ионной бомбардировки. Из рисунка видно, что островок имеет мелкокристаллическую структуру, а зерна - неправильную форму, содержат большое число дефектов, что связано, очевидно, с высокой скоростью охлаждения и кристаллизации, диффузией и взаимодействием с материалом основы и частицами органических загрязнений, присутствующими на поверхности. [4]
Пленки из окиси индия получают распылением па поверхности стекла, нагретого до 425 - 450 % раствора треххлористого индия в атмосфере с высокой относит, нл; жчостью или при темп-рах 120 - 205 конденсацией на стекле мягкого метал-лич. Стекло с пленкой из окиси индия пропускает ок. [5]
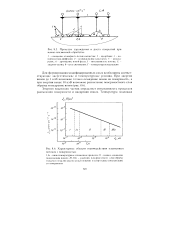 |
Процессы зарождения и роста покрытий при ионно-плазменной обработке.| Характерные области взаимодействия плазменных потоков с поверхностью. [6] |
Энергия падающих частиц определяет интенсивность процессов распыления поверхности и внедрения ионов. [7]
При ионной бомбардировке мишени наряду с процессами распыления поверхности, иопно-ионний эмис-X сии, образования радиационных дефектов и др. лронс-X ходит проникновение ионов в глубь мишени. Движущиеся частицы в результате многократных столкновений постепенно теряют энергию, рассеиваются и в конечном итоге либо отражаются назад, либо останавливаются, распределяясь но глубине. [9]
При бомбардировке поверхности твердого тела ускоренными ионами, наряду с процессами отражения ионов, распыления поверхности ( испускание нейтральных атомов), эмиссии вторичных заряженных частиц, происходит внедрение первичных ионов в кристаллическую решетку твердого тела. [10]
Заряженная пыль и металлические капли возникают вблизи поверхности электродов в плазме технологических устройств, при распылении поверхностей высокоэнергетическими потоками ионов, в условиях радиационных поясов Земли, где присутствие этих капель может заметно воздействовать на поверхности спутников. Пылевая плазма влияет как на отклонение характеристик плазмы от равновесия, так и на деградацию свойств материала поверхности в космическом пространстве. [11]
Протоны со сравнительно небольшой энергией ( порядка 100 кэв), входящие наряду с электронами в излучение, вызывающее полярное сияние, способны, как и ряд др. частиц, вызвать распыление поверхности оболочки космич. Атом, находящийся на поверхности материалов, под влиянием удара космич. [12]
 |
Классификация процессов ионно-плазменного травления. [13] |
В этом процессе для удаления поверхностного слоя материала используют кинетическую энергию ионов инертных газов. Иногда этот процесс называют физическим распылением поверхности. В зависимости от способа получения ионов и среды, в которой находятся образцы, ионное травление разделяется на два вида. [14]
Характерная особенность высококонцентрационной имплантации - получение из одного источника импульсно-периодических пучков ускоренных ионов и плазменных потоков, что дает возможность воздействовать на обрабатываемую поверхность чередующихся ионных пучков и потоков плазмы для осаждения покрытия. При этом за счет атомного перемешивания удается компенсировать распыление поверхности и повысить концентрацию внедряемой примеси. [15]
Страницы: 1 2 3
