Рентгеновская литография
Cтраница 2
 |
Принцип действия фокусирующего зл - липсоидального зеркала с многослойным покрытием для ESCA-анализа поверхности, позволяющего сфокусировать излучение с Я. и 1 нм в пятно диаметром 60 мкм. [16] |
Приведенные примеры показывают, что многослойные зеркала открывают разнообразные возможности управления рентгеновскими пучками и следует ожидать их дальнейшего внедрения во все области применения мягкого рентгеновского излучения. Упомянем в связи с этим работу [6], в которой рассмотрены рент-генооптические системы на основе МИС для осуществления проекционных схем в рентгеновской литографии - методах производства и тиражирования микросхем с субмикронными размерами, а также работу [89], в которой исследуется радиационная стойкость МИС с точки зрения использования их в качестве пред-монохроматоров и других устройств для управления пучками синхротронного излучения. [17]
Наконец, уже в течение 15 лет ведутся работы по рентгенолито-графии, призванной в будущем по мере миниатюризации микросхем заменить фотолитографию, в которой минимальный размер воспроизводимого рисунка определяется длиной световой волны. Следует ожидать, что с открытием высокотемпературной сверхпроводимости появятся новые возможности эффективного построения микросхем с субмикронными размерами, и работы по рентгеновской литографии получат дополнительный импульс. [18]
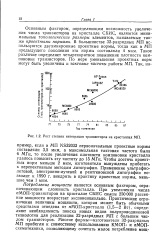 |
Рост степени интеграции транзисторов на кристаллах МП. [19] |
Чтобы достичь проектных норм меньше 2 мкм, изготовители вынуждены прибегать к перспективным методам литографии. Применение ультрафиолетовой, электронно-лучевой и рентгеновской литографии позволит к 1990 г. внедрить в практику проектные нормы, меньшие чем 1 мкм. [20]
 |
Принцип оптического. [21] |
Технология сверхбольших интегральных схем с субмикронными размерами элементов не требует обязательного образования субмикронных рельефов во всех слоях интегральной схемы. Принимая во внимание малую скорость переноса изображения пучком электронов, которая ограничивает скорость всего процесса производства микросхемы, целесообразно использовать этот прием для образования рельефа в слое, где требуется создание субмикронных элементов, а для создания микрорельефов в остальных слоях применять фотолитографию. Комбинация может включать и рентгеновскую литографию с фотолитографией. Основной проблемой смешанной литографии является достижение качественного совмещения. [22]
Уменьшение размеров компонентов является одним из наиболее важных факторов, обеспечивающих дальнейший прогресс микроэлектроники. Оно может быть достигнуто двумя взаимодополняющими путями. Первый путь базируется на использовании методов фотоэлектронной, ионной и рентгеновской литографии, второй на применении специальных технологических приемов ( методы самосовмещения), заключающихся в устранении операции совмещения в процессе литографии. [23]
 |
Чувствительность резистов к электронно - - му ( 20 кВ и рентгеновскому излучению. Ю. [24] |
В большинстве случаев резисты, созданные для электронной литографии, не удовлетворяют требованиям, предъявляемым к ре-зистам для рентгеновской литографии. США 4061829 ] хлор - и бромсо-держащие полимерные негативные ре-зисты для рентгеновской литографии. [25]
Прогнозированию надежности высокоинтегрированной аппаратуры посвящена гл. В особую главу выделены вопросы технологии БИС, СБИС и МЭА на их основе. На основе систематизации зарубежных публикаций приводятся описания методов разработки п изготовления фотошаблонов, электронной и рентгеновской литографии, технологических методов сухого травления - ионного и иошю-лучевого. [26]
В большинстве случаев резисты, созданные для электронной литографии, не удовлетворяют требованиям, предъявляемым к ре-зистам для рентгеновской литографии. США 4061829 ] хлор - и бромсо-держащие полимерные негативные ре - ю4 зисты для рентгеновской литографии. [27]
Преимущества отдельных литографических систем можно рассматривать в соответствии с рядом критериев [62]: разрешение, которое может быть получено, производительность, капитальные и эксплуатационные расходы, занимаемая площадь. В ряду всех известных литографических систем, дающих субмикронное разрешение, рентгеновская литография наиболее предпочтительна. При этой оценке, однако, не рассматривается ряд проблем, возникающих при изготовлении масок для рентгеновской литографии. [28]
 |
Эталон Фабри - Перо для рентгеновского излучения. [29] |
ОДР - нарезка на металле ( алюминий, золото) алмазным резцом на станке с управлением от ЭВМ ( макс, частота 3600 штрихов на мм; возможно Получение профиля штриха с малым углом наклона при ограничениях на форму подложки), а также голографич. УФ-ла-зеров и синхротронного излучения ( макс, частота - до неск. С помощью рентгеновской литографии изготовляют рентгеновские ОДР с многослойным покрытием, к-рыо могут работать с высокой эффективностью при больших в вплоть до нормального падения, однако их область дисперсии ограничена спектральной шириной максимума отражения покрытия. [30]
Страницы: 1 2 3