Метода - реплика
Cтраница 1
Методы реплик и оптической микроскопии, обеспечивающие получ чение информации о расслоении непосредственно на свободной кроМ ке, просты, и их результаты легко поддаются интерпретации. [1]
Методами высокоразрешающих реплик и электронной микроскопии на просвет изучены структура поверхности кремния при термическом травлении ее в ультравысоком вакууме и механизмы роста эпитаксиальной пленки. [2]
По методу реплик образен полимера охлаждают до температуры ниже температуру хрупкости ( глава IX) и подвергают деформации скола. Толщина напыленного слоя образца составляет несколько десятков ангстрем. Этот слой при рассмотрении в электронном микроскопе является оптически пустым. Затем полимер растворяют и исследуют напыленную пленку ( реплику), которая сохраняет Структуру полимера. [3]
По методу реплик образец полимера охлаждают до температуры ниже температуры хрупкости ( глаза X) и подвергают деформации скола. [4]
По методу реплик образец полимера охлаждают до температуры ниже температурь. IX) и подвергают деформации скола. Толщина напыленного слоя образца составляет несколько десятков ангстрем. Этот слой при рассмотрении в электронном микроскопе является оптически пустым. Затем полимер растворяют и исследуют напыленную пленку ( реплику), которая сохраняет Структуру полимера. [5]
По методу реплик образец полимера охлаждают до температуры ниже температуры хрупкости ( глава IX) и подвергают деформации скола. Толщина напыленного слоя образца составляет несколько десятков ангстрем. Этот слой при рассмотрении в электронном микроскопе является оптически пустым. Затем полимер растворяют и исследуют напыленную пленку ( реплику), которая сохраняет Структуру полимера. [6]
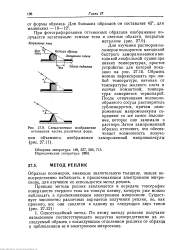 |
Схематическое изображение оттененных частиц различных форм. [7] |
По этому методу реплики получают напылением соответствующего вещества непосредственно на исследуемый образец с последующим отделением реплики от образца и наблюдением ее в электронном микроскопе. [8]
 |
Схематическое изображение оттененных частиц различных форм. [9] |
По этому методу реплики получают напылением соответствующего вещества непосредственно на исследуемый образец с последующим отделением реплики от образца и наблюдением ее в электронном микроскопу. [10]
Применение косвенного метода - метода реплик особенно необходимо при исследовании пористой структуры образцов в неразрушенном состоянии. [11]
Однако до недавнего времени метод реплик в просвечивающей электронной микроскопии не позволял получить разрешение лучше 2 - 3 нм по высотам микронеровностей; не было разработано также точных количественных методик обработки микрофотографий. В последние 5 лет был достигнут значительный прогресс. [12]
 |
Изменение электросопротивления & R / R образцов стали Х18Н10Т после I ( а, 2 ( б и 3 ( в ч выдержки при температуре старения в интервале 620 - 700 С. / - 7 - то же, что и на 142. [13] |
На электронных микрофотографиях, полученных по методу реплик на микроскопе Тесла ( рис. 144), виден характер выделения цементитных частиц в зависимости от типа нагружения после 1 и 10 циклов. [14]
Убедительно доказывает возможность разрыва по межфазной поверхности метод реплик, применяемый при электронно-микроскопическом исследовании поверхности. Это предположение неоднократно проверялось. [15]
Страницы: 1 2 3