Диффузия - донорная примесь
Cтраница 2
Метод трех фотошаблонов используется в основном для создания структур с вертикальными р - п переходами. После диффузии донорной примеси получают / г - области эмиттера и коллектора. [16]
 |
Конструкция MOSFET с вертикальной структурой. [17] |
На рис. 2.18 показана вертикальная структура типового и-канального MOSFET. Затем диффузией донорной примеси ( фосфор) создают исток с высокой концентрацией носителей - типа. Разновидностью структуры, показанной на рис. 2.18, является структура MOSFET с V-образной канавкой, которая применялась в первых типах транзисторов. Как видно из рис. 2.18, контакт стока расположен внизу, на дне кремниевой шайбы, а не в одной плоскости с затвором и истоком, как в маломощном полевом транзисторе. Такая структура позволяет создать максимальную площадь контактов стока и истока в целях снижения сопротивления выводов. Поликремниевый электрод затвора изолирован от металла истока, прилегающего к нему, слоем SiOr Канал в мощном транзисторе формируется на поверхности / - областей снизу от оксида затвора, причем / - области соединены с истоком. [18]
При диффузионном методе легирующая примесь попадает в пластинку полупроводника в результате диффузии из газовой фазы, в состав которой входит легирующая примесь. Так, для диффузии донорной примеси - фосфора в дырочный германий используют соединение, которое при нагреве испаряется, переносится потоком аргона в зону диффузии с более высокой температурой и там диссоциирует с образованием активного атомарного фосфора. [19]
Структура n - канального МДП-транзистора представлена на рис. 5.1. Транзистор создается на слаболегированной кремниевой подложке р-типа с концентрацией акцепторов порядка 1015 см-3. У поверхности подложки / методами диффузии донорных примесей или ионного легирования сформированы сильнолегированные истоковая 2 и стоковая 8 области П - ТИПЗ толщиной около 1 мкм; концентрация доноров в них превышает Ц) 19 см-3. Расстояние между сильнолегированными областями истока и стока, называемое длиной канала L, может составлять от десятых долей до нескольких микрометров. Структура обратима, т.е. любая из областей 2 8 может использоваться в качестве истока или стока. Металлические слои 3 и 7 образуют выводы истока и стока. [20]
Последовательное сопротивление коллекторной области транзистора регулируется путем введения в его структуру скрытого п - слоя. В области коллектора, где формируется омический контакт, проводится диффузия донорной примеси для образования - области. Этим обеспечивается предотвращение инверсии слаболегированного эпитаксиального слоя, так как алюминий, используемый при выполнении омического контакта, является акцептором. [21]
Исходным материалом является высокоом-ный полупроводник, например германий с р 454 - 50 ом-см. В пластинку такого германия на некоторую глубину одним из известных способов проводится диффузия донорной примеси, например сурьмы. [22]
Этим полученный закон отличается от экспоненциального. Рассмотрим случай, когда в германий с постоянной концентрацией акцепторных примесей Na производится диффузия донорной примеси, например сурьмы. [24]
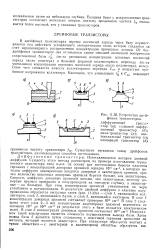 |
Устройство дрейфовых транзисторов. диффузионный транзи. [25] |
Изготавливаются методом двойной диффузии. За основу при изготовлении берется пластина германия с концентрацией донорных примесей порядка 1015 см-3, в которую методом диффузии одновременно вводятся донорные и акцепторные примеси, причем количество вводимых донорных примесей берется больше, чем акцепторных. Скорость диффузии донорных примесей меньше, чем акцепторных, поэтому до-норные примеси проникают в полупроводник на меньшую глубину, а акцепторные - на большую. При этом концентрация примесей уменьшается по мере углубления в полупроводник. В результате двойной диффузии в пластине полупроводника образуется несколько слоев ( рис. 11.32 а) - слой /, являющийся коллектором, слой 2, являющийся базой, и слой 3, являющийся эмиттером. В слое / концентрация донорных примесей составляет примерно 1015 CM-Z. Недостатком такой конструкции является сложность осуществления вывода базы. Здесь вывод базы 5 делается путем сплавления с пластиной германия проволоки из металла, который является акцептором. [26]
В настоящее время при изготовлении полупроводниковых интегральных микросхем на биполярных транзисторах наиболее широко применяют планарно-эпитакеиальную технологию. Ее отличительной особенностью является то, что коллекторные области структур создаются эпитаксиальным выращиванием слоя кремния га-типа проводимости на подложке р-типа, а базовые и эмиттер-ные - диффузией легирующих примесей в эпитаксиальный слой. Причем змиттерные области формируются диффузией донорных примесей максимально возможной концентрации. [27]
Коллекторная изолирующая диффузия позволяет значительно сократить площадь, занимаемую элементом схемы. На подложке - типа со скрытым п - слоем выращивается эпитаксиальный слой р толщиной 1 - 2 мкм. Сквозь эпитаксиальный слой р проводится диффузия донорной примеси до смыкания со скрытым - слоем. [28]
В частности, при tK 800 - 850 С на пластинах re - германия были получены пленки с электронной проводимостью, имеющие сопротивление около 1 ом-см. Без газового травления такие пленки обладают р-проводимостыо. Буторина и Толмасов [37] объясняют первое наблюдение диффузией донорных примесей из подложки. Так или иначе применение газового травления способствует улучшению качества конденсированных пленок. [29]
 |
Этапы изготовления планарного транзистора. [30] |
Страницы: 1 2 3
