Избыточная концентрация - носитель
Cтраница 1
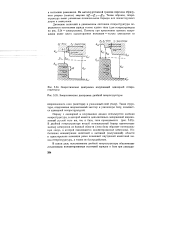 |
Энергетическая диаграмма излучающей одинарной гетероструктуры.| Энергетическая диаграмма двойной гетероструктуры. [1] |
Избыточная концентрация носителей в активной ( излучающей) области и односторонняя инжекция резко повышают внутренний квантовый выход гетероструктуры, а также ее быстродействие. [2]
Наличие избыточной концентрации носителей заряда в базе приводит также к снижению прямого сопротивления диода. [3]
Таким образом, релаксация избыточной концентрации носителей имеет экспоненциальный характер. [4]
Фн приводит к появлению избыточной концентрации носителей заряда в объеме полупроводника, росту обратных токов перехода, а также напряжения t / кэнас. [5]
Другими словами, уменьшение избыточной концентрации носителей заряда вследствие рекомбинации компенсируется расходимостью тока. [6]
После прекращения действия возбуждающего фактора избыточные концентрации носителей заряда ( например, электронов Дл и - и0) стремятся к нулю в результате процесса рекомбинации. При этом главную роль играют особые центры рекомбинации ловушки, обладающие локальными энергетическими уровнями в запрещенной зоне. Они способны захватить электрон из зоны проводимости и дырку из валентной зоны, осуществляя их рекомбинацию. Такими ловушками являются дефекты кристаллической решетки внутри и на поверхности полупроводника. [7]
После прекращения действия возбуждающего фактора избыточные концентрации носителей заряда ( например, электронов Ап п - п0) стремятся к нулю в результате процесса рекомбинации. При этом главную роль играют особые центры рекомбинации-ловушки, обладающие локальными энергетическими уровнями в запрещенной зоне. Они способны захватить электрон из зоны проводимости и дырку из валентной зоны, осуществляя их рекомбинацию. Такими ловушками являются дефекты кристаллической решетки внутри и на поверхности полупроводника. [8]
 |
Влияние скорости поверхностной рекомбинации на избыточную концентрацию неосновных носителей заряда. [9] |
Физически это означает, что избыточная концентрация носителей заряда, приходящих на поверхность, обращается в нуль вследствие рекомбинации. [10]
После прекращения энергетического воздействия на полупроводник избыточная концентрация носителей заряда в нем из-за процесса рекомбинации через некоторое время уменьшится до нуля. [11]
После прекращения энергетического воздействия на полупроводник избыточная концентрация носителей заряда в нем из-за процесса рекомбинации через некоторое время уменьшается до нуля. Это время у различных материалов полупроводника неодинаково, что необходимо учитывать в процессе конструирования полупроводниковых приборов. [12]
После прекращения энергетического воздействия на полупроводник избыточная концентрация носителей заряда в нем из-за процесса рекомбинации через некоторое время уменьшится до нуля. [13]
При высоком уровне возбуждения, когда избыточная концентрация носителей заряда сравнима с концентрацией основных носителей заряда, значениями Дп и Др в (3.2) нельзя пренебречь по сравнению с суммой П0 р0; время жизни неравновесных носителей заряда не будет постоянной величиной; решения уравнений ( 3.1 а), (3.16) примут иной, неэкспоненциальный вид. [14]
После прекращения энергетического воздействия на полупроводник избыточная концентрация носителей заряда в нем из-за процесса рекомбинации через некоторое время уменьшится до нуля. [15]
Страницы: 1 2 3 4