Осаждаемая пленка
Cтраница 3
Металлы, применяемые в качестве восстановителя, могут внедряться в осаждаемую пленку в виде примесей. Для того чтобы предотвратить этот процесс, количество используемого металла определяют, исходя из стехиометрического соотношения, и осаждение проводят при пониженном давлении паров. Если в процессе реакции металл, являющийся восстановителем, образует с галогеном соединение, которое оказывается менее летучим по сравнению с осаждаемым металлом ( и поэтому может совместно с ним конденсироваться на подложке), то условия осаждения необходимо регулировать таким образом, чтобы давление образовавшегося галогенида было ниже давления его насыщенного пара при температуре осаждения. Что касается перечисленных выше металлов, которые применяются в качестве восстановителей, то их фториды, хлориды и бромиды ( за исключением соединений с цинком), а также иодиды ( за исключением иодидов цинка и магния) являются менее летучими соединениями, чем осаждаемые металлы, входящие в состав исходных галогенидов, причем наименьшей летучестью обладают фториды, а наибольшей - иодиды. Соединения щелочных металлов с галогенами менее летучи по сравнению с восстановленными металлами, содержащимися в исходных галогенидах. Поэтому наиболее благоприятные условия для осаждения обеспечивают иодиды, а щелочные металлы в наименьшей степени подходят для использования в качестве восстановителя. [31]
При температуре процесса ХОГФ атомы меди из сплава диффундировали в осаждаемую пленку алюминия до уровня растворимости в твердом состоянии и равномерно распределялись по толщине композитной пленки. [32]
Вследствие недостаточно высокой поверхностной подвижности ионов при относительно низкой температуре подложки осаждаемая пленка содержит структурные дефекты. Кроме того, с поверхности подложки необходимо удалять сложные остаточные побочные продукты реакции. Чтобы исключить недостатки, свойственные этому процессу, разработан новый метод осаждения, который состоит в том, что на поверхности нагретой подложки после пульверизации раствора соответствующей соли кадмия в первую очередь формируется пленка CdO, которая затем полностью превращается в CdS в результате обмена анионами, происходящего при повышенной температуре в парах сульфида. В этом случае первоначальная реакция образования оксида протекает до ее полного завершения в соответствии с термодинамическими параметрами этого процесса. Кроме того, при получении CdS побочным продуктом реакции сульфирования является вода, а уплотнение кристаллической решетки сульфида в процессе реакции замещения происходит с небольшой скоростью в условиях, близких к равновесным. В целом осаждение пленки CdS представляет собой сочетание двух процессов: пульверизации раствора и химического осаждения из паровой фазы, сопровождающегося реакцией замещения. [33]
Отношение расходов SiH4 / WF6 является ключевым фактором для контроля состава осаждаемых пленок силицида вольфрама. Скорость осаждения Vd в таком режиме линейно пропорциональна расходу гексафторида вольфрама Q ( WF6) и почти не чувствительна к температуре. Реакция осаждения протекает в диффузионной области ( ограничена доставкой реагента), и степень конформности покрытия ступенек топологического рельефа ограничена углом падения газовых частиц. [34]
Основным ограничением процессов ПА ХОГФ является электрический заряд, вносимый в осаждаемую пленку, и эффекты зарядки структур ИМС, которые могут приводить к пробою тонких пленок подзатворных диэлектриков и деградации характеристик МОП транзисторов. [35]
Пополнение электролита металлическими ионами может производиться растворением анода, сделанного из металла осаждаемой пленки. Но во многих случаях применяют нерастворимые аноды из свинца или кислотоупорной стали, при этом электролит быстро истощается и необходимо все время корректировать его состав добавлением соответствующей соли. Поэтому важной для серийного производства характеристикой является стабильность электролита. Она тем выше, чем дольше может быть использован раствор без введения в него добавок или замены. [36]
Контроль скорости испарения пред ставляет собой более сложную задачу, чем контроль толщины осаждаемой пленки, поскольку при эгом необходимо регулировать температуру испа рителя. В качестве первого и простейшего приближения можно считать, что скорость испарения остается постоянной за все время испарения, если входная мощность и, следовательно, температура испарителя остаются неизменными. Такое предположение справедливо в том случае, если эффективная поверхность испаряемого вещества не изменяется вследствие шлакообразования, растягивания или сжатия испаряемого вещества и если не изменяется теплоотвод от испаряемого вещества к испарителю. Примером может служить испаритель, описанный Да Сильва [84] ( см. рис. 18), который нагревается излучением. [37]
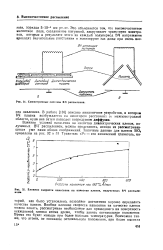 |
Симметричные системы ВЧ распыления.| Влияние скорости нанесения на качество пленок, полученных В Ч распылением. [38] |
Вообще влияние скорости нанесения на качество пленок можно понять, рассматривая необходимое для пришедшего на поверхность осаждаемой пленки атома время, чтобы занять оптимальное положение Время это будет меньше при более высоких температурах. [39]
Если подложка ( подслой) имеет случайно ориентированные зерна или аморфна, то зародыши ( зерна) осаждаемой пленки будут также случайно ориентированы, как в процессах термоактивируемого ХОГФ пленок алюминия, меди и вольфрама на поверхности двуокиси кремния. Механизм роста пленки фактически берет под контроль структуру пленки после прохождения стадии зародышеобразования. Операционные параметры, при которых происходит сильная поверхностная диффузия частиц осаждаемой пленки, шероховатость поверхности или случайные поверхностные загрязнения могут быть определяющими факторами при формировании структуры осаждаемых в процессах ХОГФ пленок. [40]
Нанесенный промежуточный лаковый слой должен быть тщательно просушен, так как от этого в значительной мере зависит целостность осаждаемой пленки металла. [41]
 |
Данные для сопоставления ртутных пленок, осажденных на стеклоуглерод предварительно и одновременно с анализируемым. [42] |
Данные табл. 9.1 показывают, что пленки ртути, формируемые предварительно, дают менее точные результаты, чем одновременно осаждаемые пленки. Очевидно, нет никаких практических преимуществ от стадии предварительного формирования пленки ртути на подложке; поэтому последующие данные всегда относятся к пленкам ртути, осаждаемым одновременно. [43]
Осаждение защитных пленок на аппаратах можно применять лишь в том случае, когда они не служат для теплопередачи илл когда осаждаемые пленки не ухудшают теплопередачу. Обработка воды для осаждения на водопроводах защитных пленок с успехом применяется в системах промышленного и бытового водоснабжения. [44]
Недостаток способа - в непременном присутствии в камере газа, что часто приводит к захвату его атомов и прочному их включению в осаждаемую пленку, а также в трудности распыления некоторых тугоплавких металлов и сплавов. [45]
Страницы: 1 2 3 4 5