Диффузионная технология
Cтраница 2
Планарная технология является дальнейшим развитием диффузионной технологии и получила свое название потому, что р-п переходы диодных и транзисторных структур, изготовленных этим методом, и соответствующие контакты к эмиттеру, базе и коллектору выходят на одну ( верхнюю) плоскость ( план) исходного кристалла. [16]
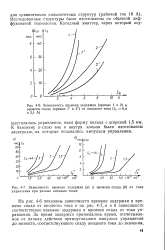 |
Зависимость времени задержки ( а и времени спада ( б от тока управления при разных анодных токах. [17] |
Исследованные структуры были изготовлены по обычной диффузионной технологии. [18]
Пленарная технология часто рассматривается как модификация обычной диффузионной технологии. Основное пре: имущество Планерной структуры заключается в том, что переходы образуются под защитным окисным слоем. В связи с этим устраняются многие проблемы, связанные с поверхностными явлениями, которые ухудшают параметры транзисторов, имеющих переходы незащищенные окисной пленкой. Пленарные транзисторы имеют меньший обратный ток и больший коэффициент усиления при малых коллекторных токах. [19]
 |
Структура фотодиодов с широким потенциальным барьером ( а и p - i - n - переходом ( б. [20] |
При производстве фотодиодов используют сплавную н диффузионную технологию изготовления р-л-переходов. Причем диффузионная технология используется для кремниевых фотодиодов. [21]
Измерения проводились на структурах, изготовленных по диффузионной технологии на бездислокационном кремнии с р 60 Ом - см. Использовались полоски шириной 1 мм с длиной эмиттерного контакта 2 мм. Напряжение пробоя эмиттерного перехода / i составляло 6 - 10 В, токи утечки через переход до пробоя - десятки микроампер. [22]
 |
Распределение примесей в р-п - р структуре, полученной методом двусторонней диффузии. [23] |
В этом заключается одно из существенных преимуществ диффузионной технологии по сравнению со сплавлением. [24]
В лавинных фотодиодах, полученных при помощи обычной планарной диффузионной технологии ( их структура показана штриховой линией на фиг. Это происходит в том случае, если поверхность легирована сильнее, чем база, поскольку тогда электрическое поле в этих частях выше, чем в плоской части перехода. [25]
Для характеристики частотного предела транзисторов, изготовленных по диффузионной технологии, вместо fa и / макс иногда указывают предельную частоту усиления по току в схеме с общиц эмиттером / 1 - частоту, на которой коэффициент усиления по току в схеме с общим эмиттером 213 уменьшается до единицы. [26]
Современные биполярные транзисторы изготавливают на основе кремния по диффузионной технологии с использованием планарного процесса. [27]
Для получения износостойких металлических покрытий может быть применена и диффузионная технология. Высокая устойчивость против кавитационной эрозии отмечена у хромомарганцовых диффузионных покрытий. [28]
Современные биполярные транзисторы изготавливаются на основе монокристаллического кремния по диффузионной технологии с использованием планарного процесса. [29]
Однако первый способ ограничен возможностями применяемой для производства тиристоров диффузионной технологии, которая не позволяет получать диффузионную базовую область тоньше 15 н - 20 мкм без существенного ухудшения других параметров тиристора. Уменьшение толщин базовых областей приводит прежде всего к существенному снижению напряжения переключения. Поэтому разрабатываются другие технологические методы получения тиристоров - эпитаксиальный и элионный. Ожидается, что сочетание этих методов с диффузионным позволит создать тиристоры с малым временем включения без уменьшения напряжения переключения. [30]
Страницы: 1 2 3 4