Концентрация - легирующая примесь
Cтраница 2
В зависимости от градиента концентрации легирующих примесей у границы раздела р - и - областей различают плавные и резкие переходы. Переход, в котором толщина области изменения концентрации примесей намного меньше толщины области объемного заряда, называется резким. Переход, в котором толщины областей изменения концентрации примесей и слоя объемного заряда сравнимы, называется плавным. [16]
Предельно достижимая при ионной имплантации концентрация легирующей примеси определяется количеством ионов, необходимых для распыления слоя атомов мишени толщиной, равной пробегу ионов в направлении, перпендикулярном к поверхности. Весьма малые легирующие добавки могут значительно изменить энергию связи атома в материале и соответственно коэффициент распыления. В результате расчет предельной концентрации легирующей примеси в случае многокомпонентных материалов остается не решенной до конца задачей. [17]
 |
Концентрации легирующих примесей и распределение приложенного напряжения в гетеропереходах. [18] |
GaAsj P, y ( концентрации легирующих примесей в этих материалах приведены в табл. 2.1), с высокой точностью согласуются между собой. [19]
Такой переход характеризуется постоянным градиентом концентраций легирующих примесей а. Распределение электрического поля в линейном переходе, показанное пунктиром на рис. 1.28, симметрично в р - и n - областях. [20]
Согласно результатам измерений вольт-фарадных характеристик, концентрация легирующей примеси в р - InP равна 8 3 - 1016 см-3. Просветляющее покрытие из SiO получают посредством вакуумного испарения вещества при температуре подложки около 100 С. Контакт к пленке CdS осуществляется с помощью индия, наносимого из расплава. [21]
Если в квазинейтральных областях существуют градиенты концентраций легирующих примесей, которые вызывают появление электрического поля, то выражение для J0 усложняется. [22]
 |
Поле потенциалов в базовой области транзистора. [23] |
Подвижность основных носителей заряда, зависящая от концентрации легирующей примеси и величины электрического поля в полупроводнике ( 7 ]; N ( х) - концентрация легирующей примеси; q - заряд электрона. [24]
На температурной зависимости внутреннего трения независимо от концентрации легирующих примесей имеется пик при Г 170 К и / 1743 Гц. Этот пик отсутствует на недеформированных НК и появляется только лишь после пластической деформации, причем высота его увеличивается с увеличением степени деформации. Аналогичного характера пики по внутреннему трению наблюдались также ранее в работах [586, 624], причем, поскольку они полностью исчезали после стравливания поверхностного слоя ( по 0 1 мм со стороны), их наличие связывалось [586] именно с наличием-преимущественной пластической деформации в поверхностном слое. [25]
Вольт-фарадные методы широко используются для измерения распределения концентрации легирующей примеси в МДП-струк-турах, структурах с контактом Шотки и в резких р-л-переходах. [26]
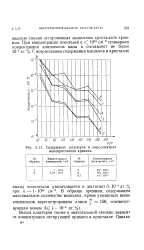 |
Содержание кластеров в масс-спектрах монокристаллов кремния. [27] |
Выход кластеров также в значительной степени зависит от концентрации легирующей примеси в кристалле. [28]
Здесь рц ( г, т) - концентрация легирующих примесей, которая зависит от времени т и координаты 2, начинающейся на поверхности раздела фаз и направленной в сторону расплава; дак ( т) - скорость кристаллизации. [29]
 |
Зависимость напряжения пробоя приповерхностной ОПЗ V от уровня легирования кремниевой подложки. [30] |
Страницы: 1 2 3 4 5