Многослойная структура
Cтраница 2
Расслоение многослойной структуры возможно при использовании некачественных склеивающих материалов, нарушениях режимов прессования и плохой отмывке склеиваемых слоев. Устранить эти дефекты весьма сложно. [16]
 |
Характеристики преобразования пленочного магниторезисто-ра для двух значений угла а.| Характеристика тонкопленочного магниторезистивного преобразователя. [17] |
В многослойной структуре, состоящих из тонких слоев ферромагнитного металла, разделенных тонкими слоями немагнитного металла, имеет место явление исключительно большого изменения электрического сопротивления. [18]
При анализе многослойные структуры часто представляют в виде комбинации двух и более транзисторных структур, между которыми существует положительная обратная связь. [19]
Термопластики представляют собой многослойные структуры, состоящие из термопластика, фотополупроводника и прозрачного проводника. Перед экспозицией термопластик заряжают коронным зарядом. При экспозиции под влиянием света в полупроводнике изменяется проводимость в соответствии с распределением интенсивности в засвечивающем луче. В свою очередь это вызывает перераспределение потенциала на поверхности термопластика. При нагревании термопластик размягчается, на его поверхности под воздействием сбалансированных электростатических сил и сил поверхностного натяжения образуется потенциальный рельеф. Стирается запись только нагревом. [20]
Степень неоднородности многослойной структуры можно характеризовать отношением L / 1, ибо для однородной пластины это отношение равно 1, а чем больше неоднородность, тем оно выше. [21]
 |
Сечение проводника полупроводниковых прибо-первого слоя металлизации J i r. [22] |
При изготовлении многослойной структуры проводят дополнительные операции: нанесение диэлектрика, фотолитографическая обработка для образования окон в диэлектрике там, где требу - 0.55 мкм ется контакт к нижней ме-галлической пленке, осаледе-ние второго слоя металла и нанесение на него рисунка. [23]
Для создания многослойных структур в ампуле помещают несколько источников примесей, обеспечивающих создание р - или га-прсводимости. Меняя их температуру, легко осуществить перенос вещества поочередно то от одного, то от другого источника. При изменении температуры характер легирования меняется не сразу, а через определенный промежуток времени - после накопления в паровой фазе легирующего элемента. [24]
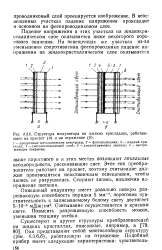 |
Структура модулятора на жидких кристаллах, работающего на просвет ( а и на отражение ( б. [25] |
Они представляют собой многослойную структуру ( рис. 4.3 6 6), работающую на отражение. [26]
Как рентгеновские зеркала многослойные структуры в практическом смысле оказались значительно более гибкими, чем обычные кристаллы. Их параметры легко можно изменять, придавая им нужные свойства. Например, подбирая период структуры в соответствии с условием (3.3), можно настраивать пик отражения на данную длину волны, или на данный угол падения, или на то и другое одновременно. Ширину пика можно варьировать в значительных пределах, подбирая пары веществ - компонентов покрытия, толщины слоев и их число. Наконец, можно так подобрать вещества и толщины слоев, чтобы пиковый коэффициент отражения был максимален. Отметим, что аналогичный резонансный характер с максимумом, положение которого определяется условием (3.3), носит и зависимость коэффициента отражения от длины волны. В связи с этим многослойное зеркало является одновременно и дисперсионным элементом для рентгеновского излучения. [27]
КНИ-методом можно получать многослойные структуры с числом слоев больше 3, относящиеся уже к трехмерным ИС. [29]
Интегральные диоды представляют собой многослойные структуры, характеристики которых определяются схемой включения транзисторной структуры. Определенное влияние оказывают паразитные транзисторы, которые образуются из-за взаимодействия рабочих слоев с подложкой ИМС. В частности, ток утечки диода в подложку определяется током коллектора паразитного транзистора. Из-за наличия тока утечки входной ток интегрального диода всегда отличается от выходного тока. Быстродействие интегрального диода, определяемое зарядными емкостями переходов и временем рассасывания, также зависит от схемы включения. [30]
Страницы: 1 2 3 4 5
