Транзисторная структура
Cтраница 1
Транзисторные структуры, изготовленные ионной имплантацией, имеют, как правило, лучшие характеристики, особенно при изготовлении СВЧ приборов. Метод позволяет изготовить область базы очень малой ширины ( менее 0 1 мкм) с высокой концентрацией примеси и, следовательно, с малым сопротивлением по всей толщине базы, что позволяет улучшить предельную частоту усиления транзистора. На рис. 9 - 13 показан профиль концентрации) примесей в транзисторных структурах, изготовленных по обычной диффузионной технологии и с применением имплантации ионов бора для создания базы. [1]
Транзисторные структуры аналоговых ИМС можно условно разделить на две группы: малосигнальные, предназначенные для построения входных каскадов, и выходные, работающие при большой плотности тока. [2]
Транзисторная структура, созданная по методу двойной диффузии, показана на фиг. Указанные размеры типичны для высокочастотного триода, работающего в режиме усиления малого сигнала с частстой до 300 мгц. [3]
Транзисторные структуры в диодном включении используются в интегральных микросхемах, выполняемых на однородных полупроводниковых элементах. В качестве диода можно применить эмит-терный переход транзистора, его коллекторный переход или их параллельное соединение, когда база транзистора служит одним выводом эквивалентного диода, а точка соединения коллектора и эмиттера - другим. Эмиттерный p - n - переход диода имеет малую площадь и образованный этим переходом диод имеет малую барьерную емкость, малый обратный ток, но и малое допустимое обратное напряжение. Коллекторный p - n - переход имеет существенно большую площадь. Образованный этим переходом диод может коммутировать больший ток, имеет значительное допустимое обратное напряжение, но также большие значения обратного тока - и барьерной емкости. Диод, полученный при параллельном соединении коллекторного и эмиттерного р-п - переходов, может коммутировать значительный ток, но характеризуется большим обратным током, равным сумме обратных токов коллекторного и эмиттерного переходов, большой барьерной емкостью и малым обратным напряжением. [4]
 |
Технология изготовления меза-дйффу-зионно-еплавного транзистора. [5] |
Полученные транзисторные структуры обрабатывают в пергидроле ( иногда в кислотном травителе), промывают и сушат. [6]
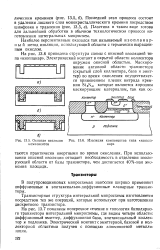 |
Окисная изоляция компонентов.| Изоляция компонентов типа изопланар. [7] |
Транзисторная структура интегральной микросхемы изготовляется посредством тех же операций, которые используют при изготовлении дискретного транзистора. [8]
 |
Распределение токов в элементе И - НЕ с простым инвертором. [9] |
Все транзисторные структуры многоэмиттерного транзистора находятся в этом случае в инверсном активном режиме, так как их коллекторные переходы смещены в прямом направлении, а эмиттерные - в обратном. Когда на один из входов многоэмиттерного транзистора будет подан сигнал О ( i / вых), соответствующий переход база - эмиттер многоэмиттерного транзистора сместится в прямом направлении. Ток, задаваемый в его базу через резистор R, проходит в цепь этого эмиттера. [10]
Перечислите основные транзисторные структуры полупроводниковых микросхем, для создания которых применяются: а) эпитак-сия, б) окисление через маску, в) ионное легирование. [11]
Площадь транзисторной структуры должна быть достаточно большой с точки зрения уменьшения теплового сопротивления и сопротивления насыщения транзистора. Ее целесообразно увеличивать для получения большой величины предельного рабочего тока. [12]
Для транзисторной структуры в диодном включении t / nep - это напряжение на том переходе ( или на обоих переходах в схеме 5), который используется в данной схеме. Сопротивление Л5 также зависит от схемы включения: это может быть либо сопротивление базы, либо сопротивление коллектора, либо их сумма. Сопротивление эмиттерной области пренебрежимо мало из-за высокой концентрации примесей в ней. [13]
 |
Распределение примесей в р-п - р структуре, полученной методом сплавления. [14] |
В транзисторной структуре, полученной методом сплавления, областью базы служит исходный кристалл полупроводника, а эмиттерная и коллекторная области представляют собой рекристаллизо-ванные слои. На рис. 2 - 7 схематически показано, что содержание легирующей примеси в эмиттерной и коллекторной областях одинаково. Так бывает, если для их получения берется один и тот же материал. В принципе это не обязательно, и при использовании с этой целью различных сплавов содержание легирующих примесей в эмиттере и коллекторе может различаться. [15]
Страницы: 1 2 3 4 5