Диффузия - неосновной носитель
Cтраница 2
При рассмотрении работы транзисторов этого типа следует учитывать двумерный характер диффузии неосновных носителей в базе. Дырки, инжектируемые вертикальной стороной эмиттерного перехода, распространяются по прямой вдоль оси у ( рис. 2.13) и, пройдя базу шириной w, попадают в коллектор. Эта составляющая дырочного тока 1У определяет в основном управляемый ток в коллекторе. [16]
Наличие переходных процессов объясняется конечной скоро - -, стью диффузии неосновных носителей в базе диода и их следует учитывать только в том случае, если схема работает с импульсами короче 1 мксек. [17]
Заменяя источник постоянной эдс импульсным генератором, можно непосредственно измерять коэффициент диффузии неосновных носителей. Импульс, имеющий форму, изо - Сраженную на рис. 562 а, дает рис Ра 0 а нение им, ульса тока на экране осциллографа кроме неосновных носителей в проводнике, почти мгновенно возникающего а форма импульса входе; 0 - вид осцидло. [18]
Прохождение тока через такой прибор не связано с относительно медленным процессом диффузии неосновных носителей, как это имеет место в обычном транзисторе, поэтому изобретатели С. Однако за время, прошедшее с момента изобретения С. [19]
В приведенных формулах не учтено время задержки t0, обусловленное конечным временем диффузии неосновных носителей через область базы. Время задержки проявляется таким образом, что если к эмиттеру приложен скачок тока, то коллектор реагирует на него с опозданием, равным времени задержки. [20]
Иными словами, ширина светового пучка не должна быть больше суммы длин диффузии неосновных носителей в р-п и р-областях. [21]
При вычислении времени жизни по измеренным длинам диффузии предполагалось, что длина диффузии неосновных носителей тока изменяется с температурой как Т - 6 [ 6J; эта зависимость незначительна по сравнению с зависимостью самого времени жизни. [22]
Диффузия примесей в германии и кремнии определяется теми же физическими основами, что и диффузия неосновных носителей. Диффузионное распространение примесей происходит из области с высокой концентрацией в область с низкой концентрацией. [23]
Это приводит к уменьшению граничной концентрации неосновных носителей заряда около р-я-перехода и к появлению диффузии неосновных носителей к переходу - идет диффузионный ток неосновных носителей, возникающих в результате тепловой генерации в объеме п - и р-областей диода, а также на омических переходах. [25]
Из (8.136) следует, что повысить предельную частоту транзистора можно или путем увеличения коэффициента диффузии неосновных носителей в базе, или уменьшением толщины базы. [26]
Как связано время пролета неосновных носителей заряда через базу диода с толщиной базы и коэффициентом диффузии неосновных носителей. [27]
Формула (1.9) представляет собой уравнение вольт-амперной характеристики полупроводникового диода в области малых токов при наличии только диффузии неосновных носителей. [28]
Электрическое поле, возникающее в обедненном слое вследствие ограниченной подвижности донорных и акцепторных ионов, способствует диффузии неосновных носителей из - области через обедненный слой в р-об-ласть. Аналогично неосновные носители заряда р-области пр перемещаются в - область. [29]
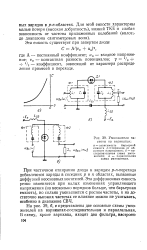 |
Умножители частоты на варикапах. а - зависимость барьерной емкости р-л-перехода от обратного напряжения. б - последовательная схема умножителя. в - параллельная схема умножителя. [30] |
Страницы: 1 2 3 4 5
